当我们将全部时间用于思考和探讨芯片设计时,我们很容易遗忘封装设计的重要性。多年来,半导体封装已经从非常基本的IC容器发展成极为专业化、设计非常精密的成品电子系统元件。半导体封装在芯片运行的每个方面都起着重要作用。3D IC、SiP等新型封装技术已经真正地将封装集成到芯片运行中。由于封装严重影响成本、可靠性、性能、占板面积以及一系列其他特征,因此封装设计和分析正变得愈加重要。

封装设计的“关注点列表”已经相当冗长,并且毫无疑问地需要采用多学科方法。从本质上讲,封装是保护IC裸片免受环境影响的外壳。封装外存在着潮湿、物理冲击和振动等威胁。此外,封装也在帮助IC散热上发挥着重要作用。由于热膨胀系数(CTE)存在差异,材料膨胀和收缩造成封装材料界面处产生热应力。最终这种应力可能造成断开和裂纹,导致失效。此外,封装也在信号完整性和电源完整性方面起着重要作用,这对于高速射频和数字应用至关重要。
因为封装设计涉及广泛的因素和问题,所以需要综合全面的方法。达索系统为封装设计的每个方面提供了深入的解决方案。3DEXPERIENCE平台便于设计人员运用先进的3D仿真器和求解器,分析研究电磁、热和机械设计考虑因素。通过基于知识的建模,能快速更新并分析设计变更。3DEXPERIENCE面向所有利益相关方提供快速更新设计的工具和基础设施,为设计流程提速。

CST Studio Suite内的求解器可广泛用于各类电磁、热和机械仿真。将其应用于封装设计与分析有助于设计人员从多科学的角度充分理解封装设计。这种一体化环境允许采用实验设计(DOE)方法指定和验证封装设计,以充分理解性能权衡取舍。

此外,达索系统还对有关工程师使用3DEXPERIENCE平台的用户体验做了大量贴心考虑。达索系统提供了先进的HPC功能和云计算服务,以提高吞吐量,同时降低仿真成本。为在基于网络的应用中查看和共享3D模型,达索系统开发出了轻量级可视化技术。
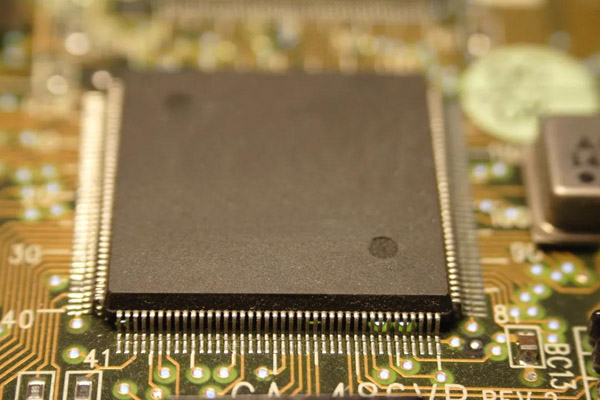
对于众多半导体产品和系统而言,封装是决定成败的因素。当站在产品生命周期管理和可靠性的角度考量时尤其如此。设计出能够在全新状态下正常工作的产品是一方面,然而随着时间的推移,运行和环境影响造成的残余应力可能导致疲劳寿命缩短甚至产品失效。对于汽车等应用,产品的实际使用寿命可能长达数十年,远超许多消费电子产品的预期使用寿命。失效带来的经济成本乃至人身伤害成本可能很高。
(采编:www.znzbw.cn)










 经营性网站备案信息
经营性网站备案信息 ICP经营许可证
ICP经营许可证 营业执照副本
营业执照副本 不良信息举报中心
不良信息举报中心